- Докладчик: Патоков Н.О.
- Тема: Исследование зарядовых свойств пленок оксида алюминия.
- Организация: АО «НПП «Элар»
К настоящему времени пленки оксида алюминия Al2O3 нашли широкое применение в производстве различных полупроводниковых приборов, например в качестве пассивирующего покрытия для солнечных элементов. В данной работе рассматривается специфическое применение пленок Al2O3 в качестве покрытия, наносимого на фоточувствительную поверхность фоточувствительных приборов с зарядовой связью (ФПЗС), освещаемых с обратной стороны подложки. В данном случае используется характерное свойство пленок Al2O3 – большой по величине отрицательный встроенный заряд, индуцирующий приповерхностное электрическое поле требуемой величины и направленности, необходимое для обеспечения высокой квантовой эффективности приборов. Цель данного исследования заключается в разработке технологии осаждения пленок оксида алюминия с максимальным по модулю встроенным фиксированным отрицательным зарядом и низкой плотностью поверхностных состояний на границе раздела Al2O3–Si.
Введение
ФПЗС c освещением с обратной стороны подложки (backside-illuminated CCDs, или BI CCDs) обладают существенными преимуществами перед ФПЗС традиционной конструкции, освещаемыми с лицевой стороны, Основное преимущество BI CCD заключается в отсутствии поглощения света в поликремниевых электродах. В настоящее время BI CCD освоены в серийном производстве рядом зарубежных компаний, причем их доля в общем выпуске ФПЗС постоянно растет. В то же время, постоянно продолжается разработка технологических способов «сенсибилизации» BI CCD за счет управления приповерхностным потенциальным профилем.
Сенсибилизация обратной стороны ФПЗС
На поверхности кремниевой подложки при контакте с атмосферным воздухом образуется слой естественного оксида, имеющий положительный встроенный заряд [1]. За счет этого в приповерхностной области обратной стороны утоненного n–канального ФПЗС формируется паразитная потенциальная яма для сигнальных носителей заряда, что снижает величину квантовой эффективности, в особенности в коротковолновой области спектра. Существует несколько известных способов решения данной проблемы:
- создание высоколегированного p+–слоя в приповерхностной области ионной имплантацией бора с постимплантационным отжигом (лазерным или термическим) [2];
- непосредственная зарядка поверхности [1];
- создание очень тонкого p+–слоя с помощью молекулярно-лучевой эпитаксии (так называемое «дельта-легирование» приповерхностной области);
- осаждение пленок с отрицательным встроенным зарядом.
Первые три способа широко представлены в отечественной и зарубежной литературе, однако у каждого из них есть свои ограничения и недостатки.
Перспективность способа, основанного на применения пленок с отрицательным встроенным зарядом, нанесенных методом атомно-слоевого осаждения (ALD), объясняется следующим:
- относительно невысокая стоимость оборудования для атомно-слоевого осаждения пленок,
- низкие температуры осаждения пленок (менее 200ºС при использовании атомно-слоевого осаждения, стимулированного плазмой);
- отсутствие жестких требований к рельефу поверхности, на которую проводится осаждение пленок;
- возможность достижения низких и стабильных значений темнового тока.
Среди материалов, которые могут иметь отрицательный встроенный заряд, в литературе упоминаются сапфир Al2O3, фторид алюминия AlF3, оксинитрид алюминия AlON, диоксид циркония ZnO2 (при определенных условиях формирования пленок), флюорит CaF2[3]. Наиболее предпочтительным представляется использование пленок оксида алюминия из-за их широкого применения в кремниевой технологии, простоты метода нанесения, наличия обширных литературных данных.
В рамках данного исследования предпочтение отдается методам термического и плазменного атомно-слоевого нанесения Al2O3 вследствие стабильности и воспроизводимости технологических и электрофизических параметров получаемых пленок.
Общие принципы процесса ALD Al2O3 хорошо изучены. В качестве основных прекурсоров в реакции наиболее часто используются ТМА (триметилалюминий) в качестве источника алюминия, а в качестве окислителя используется вода в случае термостимулированного атомно-слоевого осаждения (thermal ALD), или же O2 или O3 для плазменно-стимулированного атомно-слоевого осаждения (plasma assisted ALD) [4].
В рамках данного исследования проведен исследовались электрофизические характеристики (встроенный заряд и плотность поверхностных состояний) пленок оксида алюминия, полученных методами thermal и plasma assisted ALD.
Описание тестовых образцов
Основные характеристики исходных кремниевых пластин: p-тип, легирование бором, номинальное удельное сопротивление 12 Ом·см, ориентация (100), диаметр 100 мм, получены из слитков кремния, выращенных по Чохральскому (CZ- Si).
Пленки Al2O3 на образцах № 5, № 7 наносились по технологии Plasma- Assisted ALD; № 3 и № 4 – Thermal ALD. Параметры слоев определялись в исходном состоянии, а также и после отжига в течение 30 минут в атмосфере сухого азота при температуре 350℃. Полевые электроды МДП-структур формировались вакуумным напылением (evaporation) алюминия через теневую маску (без фотолитографии).
Электрофизические параметры полученных пленок определялись путем измерения высокочастотных вольт-фарадных характеристик с использованием измерительного комплекса CSM/Win 4200CV3 IV производства компании MDC (Швейцария).
Толщина слоя Al2O3 измерялась оптически с помощью спектрального эллипсометра и для всех образцов составляла 15 нм, показатель преломления пленок – 1,63.
Величина гистерезиса C-V характеристик определялась при комнатной температуре при изменении напряжения смещения в обоих направлениях.
Результаты измерений C—V характеристик
В качестве примера на рисунке 1 приведены нормированные вольт-фарадные характеристики, полученные для образца № 7 до и после отжига в среде азота.
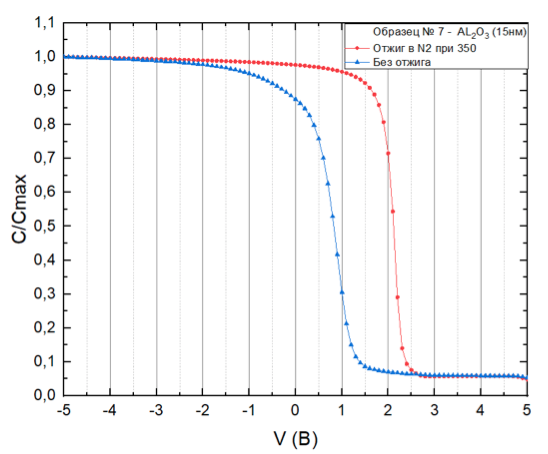
В таблице 1 представлены рассчитанные на основе измеренных C-V характеристик электрофизические параметры полученных пленок: Ufb – напряжение плоских зон, Nss — cуммарный заряд в диэлектрике и на границе раздела, гистерезис – ΔV, плотность поверхностных состояний – Dit.
Расчет параметра Nss проводится по следующей формуле:

где Сox – емкость диэлектрика (Al2O3), φms – разница работ выхода материалов контакта (Al) и подложки (p-Si), Vfb – напряжение плоских зон, Scont – площадь контакта, e – заряд электрона.
Таблица 1. Электрофизические параметры структур Al2O3–Si
Идентификатор образца | Состояние | Ufb, В | Nss, см-2 | ΔV, В | Dit, см-2 эв-1 |
3 (thermal) | до отжига | -0,6 | 4,30E+11 | 0 | 1,54E+11 |
после отжига | 0,57 | -2,76E+12 | 0 | 1,41E+11 | |
4 (thermal) | до отжига | -0,48 | 6,78E+11 | 0 | 9,38E+10 |
после отжига | 0,56 | -2,66E+12 | 0 | 1,57E+11 | |
5 (plasma) | до отжига | 0,77 | -2,40E+12 | -0,5 | 4,50E+12 |
после отжига | 8 | -3,50E+13 | 0 | 1,50E+13 | |
7 (plasma) | до отжига | 1,03 | -7,22E+12 | 0,3 | 8,00E+12 |
после отжига | 2,22 | -1,18E+13 | 0 | 3,00E+12 |
Следует заметить, что для образца №7 отрицательный встроенный заряд (порядка 10 13 см-2) значительно превышает по модулю минимально необходимую для сенсибилизации кремниевой поверхности величину, составляющую, по литературным данным, приблизительно 3∙1012 см-2 [5]. Определенная нестабильность свойств осажденной пленки, проявляющаяся в наличии гистерезиса C-V характеристики, устраняется в результате термического отжига в азоте при 350°С.
Как и следовало ожидать, для пленок, полученных методом thermal ALD, характерна наиболее низкая плотность поверхностных состояний. Однако, такие пленки не обладают достаточной величиной встроенного отрицательного заряда. Поэтому, наиболее перспективным представляется использование пленок Al2O3, полученных методом атомно-слоевого осаждения, стимулированного плазмой. Разница характеристик образцов № 5 и 7 обуславливается отличием режимов формирования пленки, детали которых компании–производители не раскрывают. Оптимальной по электрофизическим характеристикам представляется пленка Al2O3 на образце № 7.
Заключение
В данной работе рассмотрены параметры пленок оксида алюминия, осажденных по технологиям thermal и plasma assisted ALD.
Получены электрофизические параметры образцов со слоями Al2O3, позволяющие судить о пригодности технологии ALD для сенсибилизации фоточувствительной поверхности ФПЗС с обратной засветкой. Технология стимулированного плазмой осаждения пленок оксида алюминия дает возможность получения пленок с высокой по модулю величиной встроенного фиксированного отрицательного заряда порядка 1013 см-2, а также сравнительно низкой плотностью поверхностных состояний на уровне
3∙1012 см-2 эв-1.
Список литературы
- Janesick al, «SOI-based CMOS imager employing flash gate/chemosorption processing», US patent No 20110024810, 2011;
- Venezia et. al., «Backside illuminated image sensor having deep light reflective trenches», US patent No 7800192, 2010;
- Guy Meynants al., «Method of Manufacture of A Backside Illuminated Image Sensor», US patent No 8283195, 2012;
- Bachmann, «Atomic layer Deposition in Energy Conversion Applications», Wiley – VCN, Germany, 2017;
- Black L.E., «New Perspectives on Surface Passivation Understanding the Si- Al2O3 Interface», doctoral thesis, Australia, 2016.
