- Докладчик: Курташ В. А., Егоренков А. А
- Тема: Исследование оптических свойств структур фотокатода InP/InGaAs/InP.
- Организация: АО «ЦНИИ «Электрон»
Для повышения чувствительности ИК-гибридных приборов необходимо увеличение квантового выхода ИК-фотокатодов, что может быть достигнуто несколькими путями [1]. Значительный прирост квантового выхода могут обеспечить: снижение поглощения излучения подложкой InP, повышение поглощения в слое InGaAs и нанесение антиотражающего покрытия.
Целью данной работы является обоснование выбора толщин и концентраций легирующих примесей в подложке и поглотительном слое фотокатода на основе проведенных исследований оптических свойств InP и InGaAs, а также выбор материала и толщины антиотражающего покрытия с оптимизацией отражения для длины волны 1,55 мкм.
Исследование проводилось с использованием структур, изготовленных в АО «НИИ «Полюс» им. М.Ф. Стельмаха», Москва. Толщины подложек измерялись микрометром после стравливания отдельных слоев для более точного расчета оптических свойств. Ряд данных взят из сертификатов структур, предоставленных изготовителем.
С помощью ИК-Фурье спектрометра ФСМ 1202 были проведены измерения отражения и поглощения подложек InP, а также подложек с эпитаксиальным слоем InGaAs. На основе измеренных зависимостей поглощения и отражения от длины волны излучения для подложек с различными концентрациями легирующей примеси был рассчитан коэффициент поглощения 𝛼 из закона Бугера-Ламберта-Бера для длины волны 1,55 мкм. Поглощение излучения телом (A) при прохождении света через него описывается следующей формулой:

где T – измеренное пропускание, R – измеренное отражение, h – толщина.
С использованием этих данных построены зависимости поглощения излучения с длиной волны 1,55 мкм от толщины подложек, имеющих разные концентрации легирующих примесей (рисунок 1).
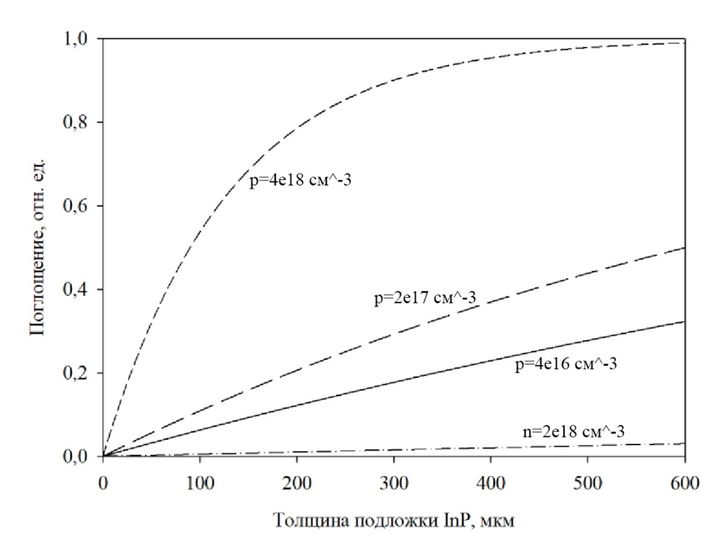
Из полученных данных можно сделать вывод о целесообразности использования подложек InP n-типа проводимости, так как они практически не поглощают излучение. Однако, ограниченный опыт использования одной подложки n-типа показал возникновение эффекта электрического пробоя структур. В дальнейшем планируется подробное изучение возможности использования данных подложек. Пока предлагается использовать подложки с концентрацией p = 4·1016 см-3, обеспечивающие наименьшее поглощения среди прочих исследованных подложек p-типа. Использование низколегированных подложек, возможно, потребует дополнительной операции создания p+-p перехода для формирования электрического контакта с низким сопротивлением.
Для расчета коэффициента поглощения эпитаксиального слоя InGaAs были использованы экспериментальные значения коэффициентов отражения от подложек, а также коэффициенты поглощения подложек InP без эпитаксиального слоя и спектры поглощения подложек с выращенными эпитаксиальными слоями InGaAs. Исходя из этого, был рассчитан коэффициент поглощения слоя InGaAs 𝛼 = 7717 см-1. На рисунке 2 показана зависимость поглощения излучения на λ = 1,55 мкм от толщины слоя InGaAs.

В используемых структурах толщина слоя поглотителя составляет 1,56 – 1,6 мкм, что обеспечивает поглощение 70% дошедшего излучения. Для достижения 99% поглощения требуется увеличить толщину InGaAs до 6 мкм, что, однако, приведет к возникновению рекомбинационных потерь, связанных с транспортом генерированных электронов к поверхности. С учетом только диффузионной модели транспорта носителей, длина свободного пробега электронов в InGaAs при NA ≤ 1018 см-3 составляет 2,3 мкм [2]. Поэтому предлагается компромиссный вариант увеличения толщины слоя InGaAs до 2,3 мкм.
Для экспериментальной проверки результатов данного исследования заказаны новые структуры толщина слоя InGaAs в которых увеличена до 2,3 мкм.
Измерения с помощью ИК-Фурье спектрометра подтвердили наличие значительного отражения излучения от подложек InP в ближнем ИК диапазоне (рис. 3), что указывает на необходимость нанесения антиотражающего покрытия. Данное покрытие должно быть, по возможности, проводящим и выдерживать прогрев в вакууме до температуры 300°С.
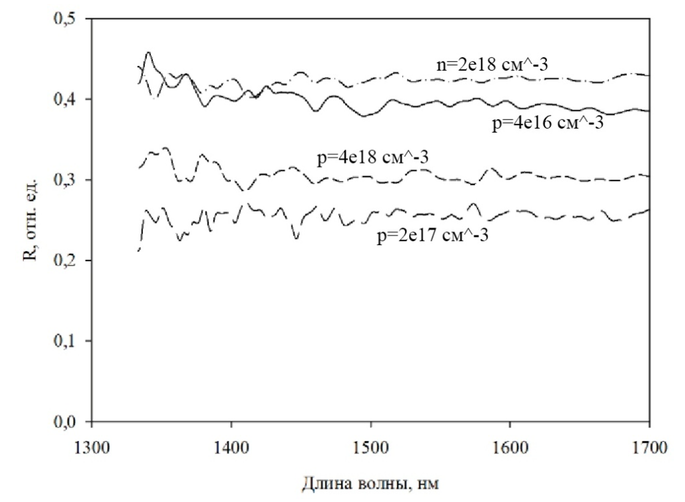
На основании полученных спектров отражения подложек InP (рисунок 3) Л. В. Лапушкиной проведен расчет параметров антиотражающего покрытия и выбор его материала. В настоящее время проводятся эксперименты по нанесению такого покрытия на имеющиеся образцы структур фотокатодов.
Благодаря вносимым изменениям, ожидаемое увеличение квантового выхода структур предположительно составит 1,8 раз.
Список использованных источников:
- Курташ В. А., Егоренков А. А. / Пути увеличения квантового выхода ИК-фотокатодов в гибридных приборах. // XI Ежегодная научно-техническая конференция молодых специалистов «Техника и технология современной фотоэлектроники». – 2020.
- Ambree, B.Gruska, K.Wandel // Semicond. Sci. and Technol. – 1992. – №7. – pp. 858-860.
Зубков Василий Иванович
СПбГЭТУ «ЛЭТИ»
Вопрос:
Использование подложек n-InP приведет к формированию p-n перехода в гетероструктуре, и, как следствие, создаст большие токи утечки структуры. Почему не рассмотреть следующий вариант. В качестве толстой подложки использовать прозрачный сапфир, а всю трехслойную гетероструктуру выполнить в планарно-эпитаксиальной геометрии? Тогда становится возможным обеспечить очень малые толщины InP-окна, что повлечет в нем кардинальное уменьшение поглощения падающего излучения.
Егоренков А.А.
Ответ:
Прямой рост гетероструктуры на подложке сапфира считаю неоправданным ввиду слишком сильной разницы в структуре кристаллической решетки и ее параметров. Это приведет к слишком большому количеству дефектов.
Можно рассмотреть вариант инверсного роста рабочих слоев на подложке InP с последующей термокомпрессией на входное окно из стекла и химическим стравливанием подложки. Аналогичный метод описан в книге «Вакуумные фотоэлектронные приборы» А.Г. Берковского, В.А. Гаванина, И.Н. Зайделя для GaAs структуры фотокатода, что применяется в ЭОП технологии. Однако при применении термокомпресии структуры с InP возможно образование вакансий на местах фосфора из-за высоких прогревов.
Айнбунд Михаил Рувимович
«АО «ЦНИИ «Электрон»
Вопрос:
Не очень понятно, откуда появилась очень конкретная последняя фраза «…ожидаемое увеличение квантового выхода структур предположительно составит 1,8 раз». Прошу пояснить.
Егоренков А.А.
Ответ:
Если считать, что отражение от поверхности InP в спектральном диапазоне работы прибора составляет 33%, а нанесение антиотражающего покрытия позволит снизить его до значений менее 1%, то поток, доходящий до поглотительного слоя увеличится в 1.5 раза. Если увеличивать толщину поглотительного слоя с 1.56 до 2.3 мкм, то поглощение в этом слое увеличится с 70% до 90%, то есть в 1.2 раза. Таким образом, суммарное повышение эффективности катода составит 1.8.
